現(xiàn)貨庫存,2小時(shí)發(fā)貨,提供寄樣和解決方案
熱搜關(guān)鍵詞:
隨著電子設(shè)備的不斷發(fā)展,功率器件的溫度參數(shù)成為了一個(gè)非常重要的研究領(lǐng)域。薩米特拉·賈格代爾將分析三種常見的功率器件材料:硅(Si)、碳化硅(SiC)和氮化鎵(GaN)的溫度參數(shù)。
硅(Si)是目前最常用的功率器件材料之一。它具有良好的熱傳導(dǎo)性能和穩(wěn)定的電特性,廣泛應(yīng)用于各種功率電子設(shè)備中。然而,硅的主要缺點(diǎn)是其低功率密度和較高的導(dǎo)通損耗。在高溫環(huán)境下,硅材料的導(dǎo)通電阻會(huì)增加,導(dǎo)致功率器件的效率下降。
Si 功率 MOSFET 和 SuperJuction 功率 MOSFET (CoolMOS):高壓 Si 功率 MOSFET 采用 D-MOSFET 結(jié)構(gòu)。主要電阻包括源極接觸 (RCS)、源極區(qū) (RN+)、溝道 (RCH)、累積 (RA)、JFET (RJFET)、漂移區(qū) (RD)、N+ 襯底 (RSUB) 和漏極接觸 (RCD)。對于 1000V Si MOSFET,RD 和 RCH 占主導(dǎo)地位,隨溫度變化。它們的溫度依賴性取決于電阻率 (ρ) 和電子遷移率 (μ)。通道長度 (LCH) 和單元長度 (Z) 很重要。閾值電壓 (Vth) 取決于 P 區(qū)摻雜 (NA)、氧化物電容 (Cox) 和電荷 (Qox)。由于其基于 ln 的作用,本征載流子濃度 (ni) 對 Vth 產(chǎn)生反向影響。柵源等效阻抗包括內(nèi)阻(Rg,int),柵極電容包括CGN+和CGP,分別連接到N+和P區(qū)域,
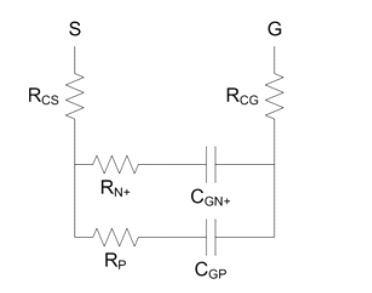
圖 1 Si MOSFET 柵極到源極的等效阻抗電路。
另一方面,CoolMOS是通過引入垂直PN結(jié)來增強(qiáng)平面DMOS結(jié)構(gòu)的器件。與傳統(tǒng)功率 DMOS 設(shè)計(jì)相比,其漂移區(qū)摻雜濃度更高,可降低導(dǎo)通電阻 (Rds,on)。電阻組件包括源極觸點(diǎn)、源極區(qū)、溝道、累積區(qū)、漂移區(qū) 1 和 2、N+ 襯底和漏極觸點(diǎn),而 Vth 和 Rg,int 仍類似于 Si MOSFET。
Si IGBT:現(xiàn)代高壓Si IGBT 采用場截止溝槽柵極結(jié)構(gòu)。通態(tài)壓降包括VP+N(P+集電極/N基極結(jié))、VNB(考慮高電平注入效應(yīng)的N基極區(qū)壓降)和VMOSFET(MOSFET部分壓降)。Si IGBT 與 Si D-MOSFET 具有相同的 Vth 和 Rg,int,但溝槽柵極不同。
碳化硅(SiC)是一種新興的功率器件材料,具有優(yōu)異的熱導(dǎo)性能和高能隙寬度。相比硅,SiC材料具有更高的擊穿電場強(qiáng)度和導(dǎo)通電阻,可以實(shí)現(xiàn)更高的功率密度和更低的導(dǎo)通損耗。此外,SiC材料的導(dǎo)熱性能也更好,可以在高溫環(huán)境下工作。因此,SiC功率器件在高溫、高頻和高功率應(yīng)用中具有巨大的潛力。
? SiC MOSFET:目前,SiC 功率器件主要采用平面柵極配置,少數(shù)采用溝槽柵極設(shè)計(jì)。雖然它們的 Ron 和 Vth 方程類似于 Si MOSFET,但它們在材料相關(guān)參數(shù)方面有所不同。值得注意的是,SiC MOSFET 的溝道遷移率隨溫度升高而升高,而 Si MOSFET 的溝道遷移率會(huì)降低。兩種器件的漏極遷移率均隨溫度升高而降低。與 Si 不同,SiC 由于注入而經(jīng)歷了最小的摻雜劑擴(kuò)散。
? SiC JFET:SiC JFET 目前大多采用溝槽柵極設(shè)計(jì),與 SiC MOSFET 不同。由于其常開特性,它們的 Ron 缺乏 SiC MOSFET 中的累積電阻 (RA)。溝道在沒有柵極偏置的情況下保持導(dǎo)電。柵源等效阻抗包括溝道電阻(RCH)。電容 CP+N- 和 CN+P+ 分別存在于 P+ 和 N- 區(qū)域之間以及 P+ 和 N+ 區(qū)域之間,如圖 2 所示。
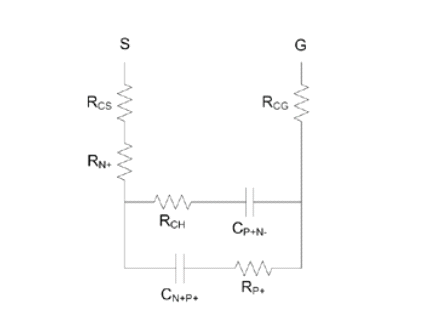
圖 2 SiC MOSFET 柵極到源極的等效阻抗電路。
耗盡型 GaN 功率器件通常與低壓 Si MOSFET 級聯(lián)。它們的特性(例如 Rg,int 和 Vth)類似于 Si MOSFET。GaN HEMT 的 Ron 由 LD(柵漏間距)和 ns(二維電子密度)描述。
另一方面,增強(qiáng)型GaN功率器件使用柵極耗盡區(qū)。該設(shè)計(jì)確保器件在沒有柵極電勢的情況下保持關(guān)閉狀態(tài),從而消除了通過 2D 電子氣的漏極-源極連接。
表征方法和結(jié)果
? Rg,int 特性:圖3 顯示了供應(yīng)商C 的SiC MOSFET 在5~100MHz 范圍內(nèi)的整體阻抗。可以看出,在 27.5MHz 時(shí),阻抗曲線反映了串聯(lián)電阻 (Rg)。供應(yīng)商 A 的 Si MOSFET 和 Si IGBT 表現(xiàn)出與溫度相關(guān)的 Rg 行為:增加直至大約 75°C,然后下降。同時(shí),與供應(yīng)商A的Si MOSFET和Si IGBT相比,供應(yīng)商D的SiC JFET表現(xiàn)出明顯較差的Rg特性。這阻礙了其作為熱傳感元件(TSEP)的可行性。
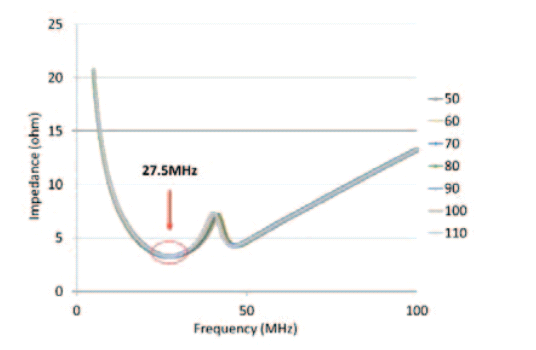
圖3 SiC MOSFET的Tj-阻抗關(guān)系
? 通態(tài)電阻(Ron) 特性:圖4 顯示1200V Si MOSFET 的Ron 最高為80 歐姆,而其他6 種器件的Ron 低于1 歐姆。其中,650V CoolMOS 的 Ron 最大,而 650V eGaN HEMT 的 Ron 最小。CoolMOS 在 0.6 歐姆/°C 時(shí)表現(xiàn)出最高的 Tj 系數(shù),而 GaN HEMT 共源共柵在 0.2 歐姆/°C 時(shí)表現(xiàn)出最低 Tj 系數(shù)。此外,所有器件的 Ron 的 Tj 系數(shù)范圍約為 0.4~0.6 歐姆/°C。
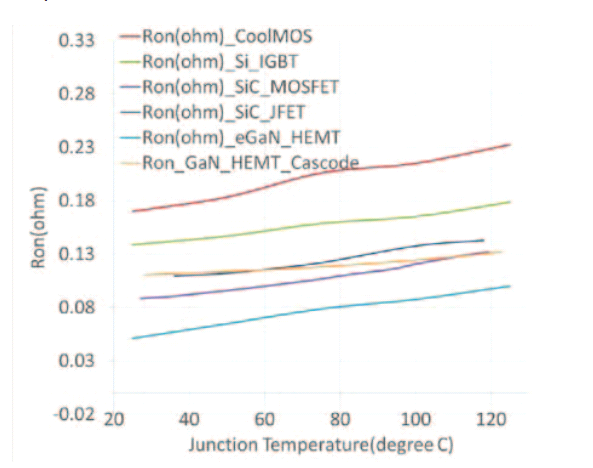
圖 4 不同 Tj 下的 6 個(gè)器件及其 Ron。
? 閾值電壓(Vth) 表征:閾值電壓(Vth) 評估是在除SiC JFET(保持常開狀態(tài))之外的各種器件上進(jìn)行的。在本次評估中,柵極和漏極被短路。圖 5 顯示了 GaN HEMT 共源共柵 Vth 測量的 Ids-Vgs 曲線特寫。在寬帶隙 (WBG) 器件中,SiC MOSFET 表現(xiàn)出最低的 Vth,約為 11.2V。測試的 eGaN HEMT 緊隨其后,顯示出隨溫度變化的波動(dòng),不適合 TSEP。來自同一制造商的另一款 100V eGaN HEMT 具有線性 Tj 系數(shù),GaN HEMT 共源共柵的 Vth 為 2.22.4V,主要由低壓 Si MOSFET 決定。
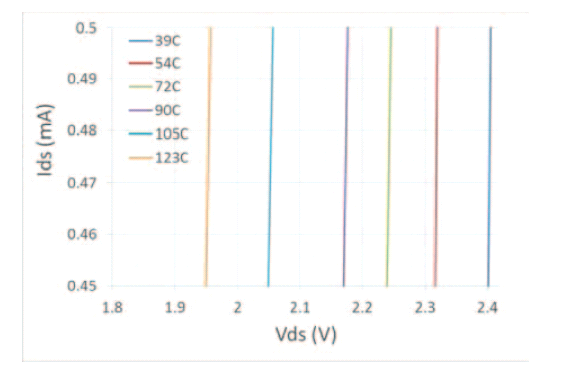
圖 5 用于測量 Vth 的 Ids-Vds 特征曲線。
我們進(jìn)行了一項(xiàng)實(shí)驗(yàn),研究不同 Si、SiC 和 GaN 功率器件中的三種 TSEP——內(nèi)柵電阻 (Rg,int)、通態(tài)電阻 (Ron) 和閾值電壓 (Vth)。
與 Si 相比,Ron 和 Vth 對于寬帶隙 (WBG) 器件表現(xiàn)出更有利的溫度系數(shù)。然而,將它們用作 WBG 應(yīng)用的 TSEP 需要增強(qiáng)的傳感技術(shù)和更高的采樣率(由于更快的開關(guān))。Rg,int 的溫度系數(shù)在制造商之間差異很大,并且僅與少數(shù)器件相關(guān),因此在其應(yīng)用中需要仔細(xì)考慮。